Epitaxie din faza gazoasă
pelicule de siliciu epitaxiale crescute pe siliciu și substraturi dielectrice (safir) pentru utilizare în reacțiile chimice sunt cel mai frecvent utilizate în tehnologia microelectronică și sunt depozitate la amestec vapori de gaz, ca urmare a uneia dintre următoarele procese.
1. Reacția de reducere a compușilor cu halogenhidric (metoda clorură)
SiCI4 + 2H2 ↔Si + H CI ↑
2. Reacțiile compuși cu halogenuri de siliciu disproportsionirovapiya
2SiCl2 ↔SiCl4 + Si
3. Reacții de piroliză de silan (sau hidrură de silan metodă)
SiH4 ↔Si + 2H2 ↑
4. Reacția de Gazotransportnge
Si + 2HCl↔SiCl2 + H2 ↑
SiCl2 + H2 ↔Si + 2HCl
Rețineți că reacțiile de mai sus sunt cumulative în natură și nu descriu întreaga varietate de procese inflowing în timpul procesului de epitaxială. În acest caz, de multe ori nu există nicio certitudine în ceea ce privește răspunsul la întrebarea, în cazul în care, de fapt, să aibă loc reacțiile chimice menționate mai sus. Într-o abordare, vorbim despre progresul procesului pe un substrat, care joacă rolul unui catalizator, accelerând creșterea stratului epitaxial datorită parametrilor săi fizici. Într-un alt procedeu având doar curgere în fază gazoasă, când substratul atomii de siliciu deja formate sunt introduse sub forma unui fascicul atomic, bombardează suprafața substratului. În această secțiune nu va lua în considerare metodele epitaxia prin transfer direct de la sursă la substratul de siliciu într-un vid, epitaxie fascicul molecular, sublimare, și așa mai departe. E. Care sunt dedicate paragrafele respective.
Metoda de clorură pentru producerea filmelor epitaxiale de siliciu este cea mai dezvoltată în industria internă. Ca reactivi de pornire prima reacție folosind tetraclorura de siliciu (SiCI4), triclorosilanului (SiHCl3), diclorsilan (SiH2 Cl2) și m. P., dar cel mai frecvent tetraclorura de siliciu SiCI4.
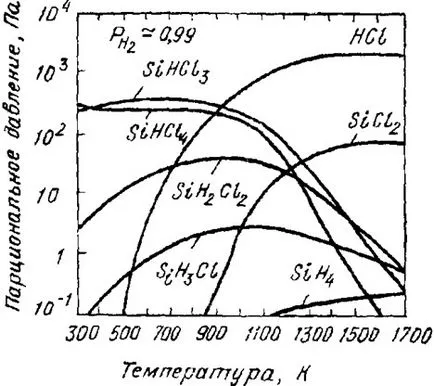
Fig. 1. Dependența de temperatură a presiunii parțiale de echilibru a compușilor produși în fază gazoasă, la o presiune de 1 atm, și raportul dintre CI / H = 0,01
In conformitate cu termenii echilibrului chimic, un exces de hidrogen cu prima reacție este o formă de siliciu și la depunerea sistemului gravare cu acid clorhidric HCl gazos poate fi realizată din substratul de siliciu. Vom explica acest lucru mai detaliat. După cum sa menționat deja, prima reacție este de a generaliza. De fapt, în sistem au loc, cel puțin, următoarele reacții:
SiCI4 + H2 ↔SiHCl3 + HCI,
SiHCl3 + H2 ↔SiH2Cl2 + HCI,
SiH2 Cl2 ↔ + SiCl2 + H2
SiHCl3 ↔SiCl2 + HCI,
SiCl2 + H2 ↔Si + 2HCl,
Fig. 1 prezintă dependența compoziției amestecului și temperatură pentru o tehnologie utilizate în mod obișnuit în raport cu concentrația de clor din concentrația de hidrogen este egal cu 0,01. Imediat o serie de concluzii din cele de mai sus.
1. Toate reacțiile chimice sunt reversibile, adică În anumite condiții, rata de depunere de siliciu poate fi negativ (Fig. 2). Acest fapt este utilizat pe scară largă în cazurile în care este necesar, de exemplu, la etch suprafața substratului imediat înainte de depunere. Equilibrium astfel poate fi ușor deplasată spre stânga prin creșterea concentrației.
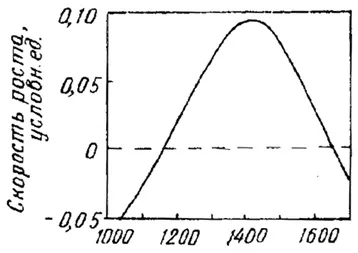
Fig. 2. Dependența ratei de creștere a temperaturii siliciu substrat prin depunere chimică de vapori
2. După cum se poate observa din Fig. 1, fiecare temperatură corespunde compoziției amestecului de gaze, precum și rata de creștere este determinată direct de această valoare, cea mai mică schimbare a temperaturii determină automat o modificare a ratei de creștere și apariția defectelor.
3. Procesul de acoperire film poate fi controlat ca viteza reacției chimice, iar viteza proceselor de transfer de masă, adică. E. Reactanții de admisie și condițiile de evacuare a produselor de reacție. Este în acest sens și mecanisme bazate pentru gestionarea procesului de creștere.
4. După cum se poate observa din lista reacțiilor este prezentă și sistemul compus instabil SiCl2 diclorura de siliciu. capabilă nu numai hidrogen, ci și pentru a recupera disproporționată pentru a doua reacție.
Procesul de clorură, în general, realizată în intervalul de temperatură 1050-1300 ° C (funcționare tipică), rata de creștere de ordinul a 1 micron / min, concentrația de tetraclorură de siliciu SiCI4 se menține la 0,5-1%, viteza gazului de 0.1-1 m * s - 1 (în funcție de condițiile specifice de depunere). Odată cu creșterea concentrației de tetraclorură de siliciu SiCI4 să reacționeze, și din cauza condițiilor de reacție pot fi create gravură substraturi de siliciu. Când concentrația de SiCI4 scăderea temperaturii substratului determină creșterea policristaline și amorfe filme chiar, în timp ce creșterea temperaturii substratului conduce la o densa straturi singur cristal. Aceste modele pot fi rezumate în diagramă.
Una dintre metoda majore de clorură dezavantaje epitaxia constă în faptul că, la temperaturi ridicate ale substratului (1200-1250 ° C) are loc prin difuzie apreciabilă a impurităților din substrat în stratul epitaksialshy în creștere, t. E. Are loc procesul de auto-dopaj. Auto-dopante modificări ale profilului concentrației în sistemul strat-substrat epitaxial. Filmele obținute prin această metodă, acest efect este sporită de prezența în faza gazoasă, compușii care conțin clor, care pot cauza subtăiere și transferul ulterior al impurităților din partea din spate a substratului. Pentru a reduce parțial efectul auto doparea este folosit în general pentru a crea un profil al concentrațiilor în structurile de impurități semiconductoare cu o valoare mică a coeficientului de difuzie, de exemplu, antimoniu sau fluorură de arsen în schimb.
Metoda Hidrură de creștere straturilor epitaxiale pe baza treia reacție de piroliză silan la temperaturi de 1050-1100 ° C. Reducerea temperaturii și absența clorurilor scade semnificativ efectele auto-doping. Dezavantajele metodei includ un puternic reactivi de toxicitate și posibilitatea exploziei reacției de descompunere spontană a silan în fază gazoasă. Când fluxul de acesta din urmă a agregatelor substrat toamna, constând în principal din particule de siliciu amorf, ceea ce crește în mod dramatic deficiența filmului în creștere. crește spontan odată cu creșterea temperaturii de piroliză, concentrația de silan în amestec, în prezența urmelor de apă H2O sau O2 oxigen. Mod de depunere Temperaturile tipice de proces metoda hidrură definită în intervalul de 1050-1100 ° C, compoziția amestecului (4% SiHl4 + 96% argon, heliu sau hidrogen), o viteză a depunerii de 0,2-2 m / min.
Utilizări pentru producerea straturilor epitaxiale de reacții disproportionare siliciu sau reacții în transportul gazelor nu este primit în prezent o aplicație practică la scară industrială, cu toate cunoștințele necesare pentru înțelegerea proceselor de creștere epitaxială utilizate în metodele și pentru eventuala producția de filme din alte materiale importante pentru microelectronică.
reacția de disproporționare poate fi, de asemenea, pusă în aplicare într-un proces deschis, dar este proiectat pentru procesele de interior sau o fiolă. Să presupunem că este necesar să se obțină un film epitaxial de siliciu folosind următoarea reacție de disproporționare:
Si + SiI4 ↔ 2SiI2
Acestui flacon i s-a încărcat într-un cuarț Si siliciu și I2 iod. flacon a fost evacuat și plasat într-un cuptor dvuhzonovuyu astfel încât o parte a acestuia cu primeri de siliciu este la o temperatură T1. iar celălalt la T2 și conține siliciu, care servește ca sursă, și T1> T2. O caracteristică a reacției de disproporționare este o schimbare de direcție, în funcție de temperatura de reacție. Când T2 se merge de la stânga la dreapta, cu SiI4 preformate interacționează cu materialul sursă, formând instabil compus gazos SiI2. Datorită fluxurilor de difuzie termică SiI2 diffuses la, substratul în care reacția merge de la dreapta la stânga, la temperatura T1. SiI4 nou formată din nou difuzată în regiunea sursă și t. D.
Rețineți că, în acest caz, depunerea are loc la temperaturi relativ scăzute (circa 1000 ° C) temperaturi, cantitatea de substanțe străine introduse în sistem. minimă, ceea ce reduce posibilitatea de contaminare a filmului. În plus, în conformitate cu pre-curățat destul de ușor. Cu toate acestea, dificultatea de mecanizare, metoda de productivitate scăzută fiolă este grav viciat.
Procesul de creștere filmelor epitaxiale din faza gazoasă cuprinde în mod tipic următoarele etape principale.
Etapele filmelor epitaxiale în creștere din faza gazoasă
1. Prepararea substratului plachetelor cu o orientare selectată și un grad predeterminat de perfecțiune de suprafață.
2. Sistem de curățare pentru cultivarea de substanțe străine.
3. Se încarcă plăcile în reactor.
4. Purjarea reactorului cu un gaz inert și hidrogen.
5. Încălzirea plăcilor din reactor și condițiile de creare de corodare a gazelor, în scopul de a curăța plăcile și îndepărtarea lustruirea mecanică afectarea stratului de suprafață.
6. Crearea condițiilor pentru modul de depunere de film.
7. Reactivi pentru nutrețuri de precipitare și (dacă este necesar) doparea filmului epitaxiale.
8. Încetarea reactanti de alimentare și de purjare a sistemului cu hidrogen.
9. Reducerea cu un program predeterminat de temperatură în reactor până la complet oprit încălzirea.
10. Sistem de purjare cu gaze inerte.
11. Descarcarea reactor.
În prezent, o muncă intensă cu privire la crearea unui sistem complet automatizate care deservesc acest ciclu optim.
Optimizarea creșterii epitaxiale este imposibilă fără o analiză detaliată a mișcării în amestec reactor. De exemplu, ia în considerare condițiile de fluxuri de curgere, în cel mai simplu din reactor orizontal este ilustrat în Fig. 3.

Fig. 3. Schema simplu din reactor orizontal
După cum se vede din această figură în reactor la diferite puncte ale sale există condiții brusc diferite. Lângă pereții de delimitare sunt zone în care viteza de curgere, temperatură, concentrațiile reactanților pot varia considerabil de valorile caracteristice pentru fluxul de intrare a amestecului format. Studiind cinetica formării filmelor, ar trebui să ia în considerare procesele de transport ale reactivilor prin limita la amestecul de substrat și îndepărtarea produșilor de reacție din ea.
Pentru a realiza uniformitatea filmelor depuse este necesară pentru a asigura condiții egale pentru toate substraturile care în prezent este practic imposibil de a figura în reactor.
Tehnologia epitaxial dezvoltat mai multe tipuri de reactoare orizontale și verticale, prezentate schematic în Fig. 4 (un reactor de tip orizontal, - un tip de reactor vertical).
Reactoare verticale asigură cele mai bune condiții pentru o încălzire uniformă a substraturilor și uniformitatea în amestec gazos de intrare compoziție. Poate fi încălzit printr-un inductor de înaltă frecvență externă încălzirea titularului substrat grafit, sursa externă de lumină sau o rezistență de încălzire internă, pereții reactorului poate fi răcit cu forța, reducând probabilitatea de contaminare a substraturilor.
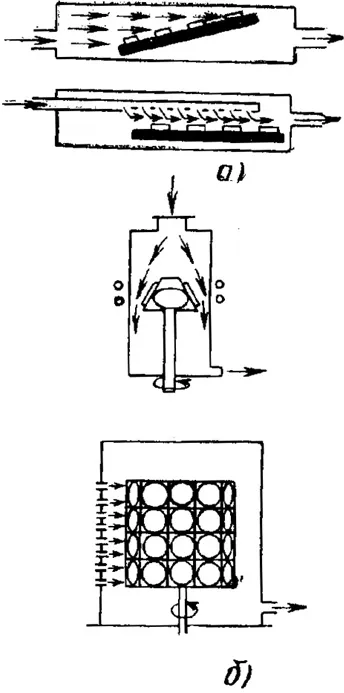
Fig. 4. Tipurile de reactor: a - orizontal; b - vertical
reactoarele verticale sunt acționate intermitent, adică dezavantajul semnificativ, cu toate acestea, prezența în instalarea mai multor reactoare comutate simplifică problema (până când, de exemplu, într-una dintre ele există o acumulare de filme, cealaltă neîncărcată și t. D.).
Doping a structurilor de siliciu epitaxială produse prin intermediul grupurilor elemente III și V sunt introduse în procesul de epitaxie sub formă de compuși volatili. Cele mai potrivite sunt cloruri și hidruri ale elementelor respective, în special cloruri: RSl3. AsCl3. SbSl3. SbCI5. BCI3. BBr3. și fosfina PH3. arsina AsN3. diboranul B2 H6. stibiniu SbH3. și mai preferabil utilizarea hidrurilor.
Există următoarele metode principale de dopaj straturilor epitaxiale de amestecuri de gaz-vapori, lichide și ligaturi de gaz cu descărcare.
Când dopante impuritățile din amestecul de gaz-vapori este diluat sursa amestec de gaz inert cu o hidrură de volatile, se adaugă la curentul principal de intrarea în reactor.
O metodă promițătoare pentru controlul concentrației impurităților în stratul epitaxial în timpul creșterii este metoda alierii sau descărcare electrică este gaz. În acest caz, între electrozi într-un reactor, o scânteie de descărcare este generată, în care procesul de pulverizare a materialului de electrod. antimoniu aliaj Ca material de electrod pentru producerea straturilor de siliciu cu tip n de conductivitate se utilizează D + 0,1% P sau D + 1%.
Pentru a obține straturi epitaxiale având de tip p conductivității sunt utilizați electrozi din LaB6 lantan borură. AlB12 borura de aluminiu. concentrația de C carbura de bor B4 a fost introdusă în schimbarea impurităților în fază gazoasă, reglarea frecvenței de descărcare prin scânteie. Aparatură pentru epitaxie de siliciu prezentat în Fig. 5.
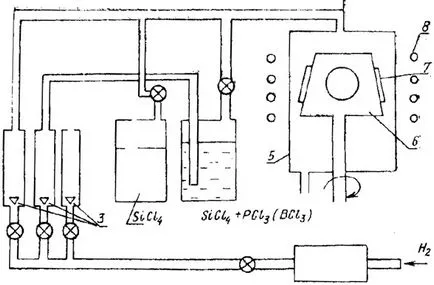
Fig. 5. diagrame de instalare pentru epitaxie siliciu
Hidrogenul este alimentat într-un sistem de purificare, unde este complet eliberat de impurități prin care trece prin catalizator (oxigen post-combustie) și paladiu (platină) filtru. fluxul de hidrogen este reglat de o supapă, iar debitul poate fi controlat prin rotametru flotanta 3. Într-o pereche corespunzătoare captura hidrogen barbatore de tetraclorură de siliciu SiCI4. care conține impurități, iar amestecul gazos vapori intră în reactorul 5 în cazul în care un suport de substrat 6 localizat pe substratul 7. Suportul substrat este încălzit de către generatorul de inductor RF 8 și se poate roti pentru a netezi fluctuații și câmp de temperatură care creează condiții de creștere identice pentru toate substraturile.